Что за припой под крышкой процессора
С выходом четвертого поколения процессоров intel Core под названием Haswell, мной был приобретение процессора intel Core 4770K, надежды и мечты были огромные, но все было омрачено перегрев, о разгоне выше 4,1 MGz можно было забыть смело и навсегда. Всему виной стал новый термоинтерфейс между теплораспределительной крышкой и кристаллом процессора. Так почему intel стал применять пластичный термоинтерфейс вместо припоя?
О скальпировании intel 4770k и роли теплораспределительной крышки я уже писал ранее и только теперь можно смело сказать по чему intel намерено на протяжении долгих лет использует тонкие чем надо крышки.
Этот вопрос не давал покоя мне долгое время и я стал изучать более детально все составляющие компоненты процессоров начиная с линейки Haswell. В одно и то же время линейка процессоров на socket 2011, 2011-3 спокойно использует под теплораспределительной крышкой припой.
Что же получилось?
Главная задача состояла в том:
а. это должно было просто заработать;
б. необходимо было выявить все подводные камни технологии кустарной пайки.
Собственно, гонять 35-ватный процессор в различных тестах особенно смысла нет (на моей материнской плате множитель у него заблокирован), хотя даже в простейших тестах, которые я проводил для себя до и после, никакой особой разницы я не заметил, буквально градус-другой, хотя всё это могло стать следствием случайного стечения обстоятельств.
Отмечу, что если мой образец ранее спокойно работал с оперативной памятью на частоте 3533 МГц, то после данной процедуры он потерял возможность стабильной работы при сохранении ранее существующих параметров, и мне пришлось откатиться на 3466 МГц. Это как бы тоже повод насторожиться и хорошенько всё переосмыслить.
Как паять кремний и медь?
Кремний и медь совершенно разные материалы, кремний ( Si ) имеет внешний вид металла, но остается по восприятию как стекло (SiO2 ) , тоесть хрупок. Теплопроводность довольно хорошоя, примерно 150 Вт / (м * К) и тепловое расширения относительно низкое 2,6 мкм / (м * К).
Медь (Cu) это пластичный металл, обладает очень хорошей электропроводностью и теплопроводностью. Тем не менее тепловое расширение большое 16,5 мкм / (м * К), это больше в 6 раз, чем у кремния. Как все спаять, обычный оловянный припой, на пример такой Sn60Pb40, подходит отлично для пайки медных проводов, не подойдет, все припои на основе олова не прилепают к кремнию. Кроме того, затвердевание олова ведет к большому тепловому напряжению внутри материала. Это тепловое напряжение может вывевти из строя кристалл процессора. Известный материал способный прилипнуть к меди и кремнию это Индий. Одновременно с этим застывающий индий не дает большой усадки, это приводит к небольшому коэффициенту термического напряжения внутри кристалла процессора. Теплопроводность индия не так высока как у меди, равна (300 K) 81,8 Вт/(м·К). Кроме того индий очень пластичен, это позволяет подложке, относительно теплораспределительной крышке, расширяться без повреждений. Индий имеет температуру плавления 157 ° С.
Теперь сама операция
В качестве припоя есть несколько интересных вариантов, первый это ПОИН-52, с температурой плавления 120 °C. Альтернатива этому - сплав Розе с температурой плавления 94 °C
реклама
В итоге для начала я остановился на втором варианте, однако применять его для производительных ЦП совершенно не стоит, так как ваш новый термоинтерфейс вполне может расплавиться в процессе эксплуатации.
Я использовал паяльную станцию Магистр Ц20-М с возможностью регулирования температуры жала, а также термостолик Магистр Ц20-Т-1.0, также с возможностью регулирования температуры.

Оборудование для эксперимента
Сначала я занялся термораспределительной крышкой, которая представляет собой никелированную медную пластину с выпуклостью в месте контакта с кристаллом. Облуживание проводилось при температуре жала паяльника 135 °C.

В итоге у меня получилось
Облудить теплораспределительную крышку у меня сразу не получилось. Адгезии припоя к ней совершенно нет. Тогда я использовал наиболее доступный флюс (самодельный), который представлял собой сосновую канифоль, растворённую в медицинском спирте. После применения флюса я смог облудить площадку.
Припой, как все выглядит.
В настоящее время процессоры производятся и имеют внешний вид кремниевой микросхемы. Кремний является основным материалом для создания процессоров, обладая кубической кристаллической решеткой можно создавать идеальные слои на атомном уровне. Таким образом после создания интегральной схемы, на аерхней части подложки будут размещены металлизированные площадки для соединения чипа с печатной платой, припой в виде шариков обеспечит надежность соединения чипа. Сама матрица чипа, будет производить и выделять достаточно большое количество тепла, относительно своих физических размеров, по этому нужен хороший теплоотвод . Одновременно возникает другая проблема в текстолите socket LGA, его толщина всего около 1,17мм (процессор Haswell ), но процессор Skylake имеет толщену текстолита около 0,78 мм. Текстолит будет давать идеальное подключение к контактам LGA в гнезде материнской платы . Главная проблема, как соединить кристалл, изготовленный из кремния и теплораспределительную крышку, произведенную из меди. Медь имеет теплопроводность около 400 Ват, плюс она доступна. Есть много способов все это соединить, но реально мы столкнемся с множеством факторов, самый главный — это максимальная температура которую может выдержать чип кремния и теплопроводность совместимых материалов.

Вся правда о пайке или скальпирование CPU
На рисунке видно как схематично выглядит процессор intel поколений lvy Bridge, Haswell, Skylake. Видно что, подложка соединяется с печатной платой через столбики припоя, которая в конечном итоге соединяет процессор с socket LGA. Виден так называемый не долив, тот что на печатной плате, основание и выступающая часть имеют разные коэффициенты теплового расширения, таким образом недолив защищает процессор от саморазрушения, вызванного разностью коэффициента теплового разрушения. Теплораспределительная крышка будет проводить тепло от подложки к радиатору, который будет крепиться на теплораспределительную крышку сверху. Термоинтерфейс должен быть пластичным и должен компенсировать все движения из-за разности теплового расширения, без повреждений кристалла процессора. В зависимости от типа процессора, между подложкой и теплопроводящей крышкой, можно применять обычную термопасту или припой.

Вся правда о пайке или скальпирование CPU
Теперь сама процедура пайки
Я положил термораспределительную крышку на паяльный столик, выставив его температуру 135 °C, сверху я положил вверх ногами кристалл с основанием, придавив сверху грузом (примерно 300 гр).
Я выдерживал всё при этой температуре где-то 5 минут, чтобы всё гарантированно расплавилось, после чего понизил температуру столика до 50 °C и ждал, пока всё остынет естественным образом.
Самое сложное во всём этом оказалось ровно выставить термораспределительную крышку относительно кристалла, тем более что выпуклость под кристалл расположена не точно по центру, и крышка всё время заваливалась, пришлось сориентировать груз таким образом, чтобы его центр массы компенсировал заваливание крышки вбок. Но и выставить габариты по перевёрнутой крышке оказалось довольно непросто. В итоге всё получилось с пятой попытки.
Теперь было необходимо приклеить крышку обратно. В силу ряда причин я решил не использовать для этого герметик, а воспользовался эпоксидным клеем, состоящим из смеси смол ПО-300/ЭД-20 и оксида титана. Я взял шприц с тонкой иглой и аккуратно замазал клей в щель под крышку и немного примазал извне, для прочности. Сушил на столике два часа при температуре 70 °C.
В общем вещь получилась очень дубовая, сорвать крышку процессора ещё раз, так чтобы сохранить целостность конструкции, у меня уже бы не получилось, зато я абсолютно гарантировал механическую целостность нового термоинтерфейса.
Самое не приятное.
В процессе пайки индий будет сокращаться, в результате поверхность кремния и крышки будут стягиваться, в результате выходит кривая поверхность теплораспределительной крышки. Интенсивное термоциклирование может привести к повреждению припоя , напряжение при растяжении внутри припоя приведет к образованию пустот. Раз за разом, примерно за 200-300 термических циклов, это неизбежно приведет к образованию трещин в припое по углам на припое чипа кремния, это не избежно приведет к образованию трещин на сомом кремнии что выведет процессор из строя. Появление пустот и трещин в основном зависит от площади припоя на кристалле кремния, то есть чем больше площадь кремния тем лучше. Малый размер кристалла, ниже 130 мм ² , а это старые знакомые — lvy Bridge, Haswell, Skylake будут способствовать образованию пустот а затем и трещин, при чем это не избежно. Тем не менее процессоры среднего и большого размера кристалла, выше 270 мм ² а это Haswell-E socket 2011 не показывают значительного образования трещин при термоциклировании.
Вот и ответ на главный вопрос, для чего инженеры intel не применяют припой а используют термопасту. Отсюда тонкая и кривая теплораспределительная крышка процессора, должна играть, компенсируя сжатие. Так что я не вижу другого объяснения, более чем логического. С другой стороны по чему такая плохая эта термопаста.
Пробный камень в попытке повторить заводскую процедуру пайки кристалла к теплораспределительной крышке в кустарных условиях. Для самого первого эксперимента выбран бюджетный вариант процессора Athlon 200Ge.
Все мы знаем, что основные производители центральных процессоров фирмы Intel и AMD на своих бюджетных и не очень моделях иногда применяют более дешёвый термоинтерфейс. Рядовой пользователь обычно не обращает внимание на термопасту под теплораспределительной крышкой, да и не задумывается об этом.
реклама
Для любителей оверклокинга, когда каждый градус на счету, этот момент может оказаться весьма критичным. Лучшим термоинтерфейсом считается припой, наносимый в заводских условиях в процессе производства.
Для желающих улучшить свой процессор в домашних условиях, в качестве термоинтерфейса рекомендуется так называемый "жидкий металл". Однако у меня родилась идея попробовать воспроизвести заводскую технологию пайки в кустарных условиях и посмотреть, что из этого получится.
Так как эксперимент был заведомо рискованный, в качестве подопытного образца я выбрал наиболее дешёвый из доступных вариантов Athlon 200ge. TDP процессора всего 35 Вт и проводить для него подобную процедуру совершенно бессмысленно. Поэтому данный эксперимент был лишь этапом подготовки к полноценному эксперименту над 2400G, с его последующим комплексным тестированием. Здесь же я поставил задачу просто проверить, возможно ли это, и какие подводные камни могут при этом возникнуть.

реклама
Процедура скальпирования стандартная. Я немного надрезал лезвием герметик, после чего зажал процессор под углом в тиски и без особого труда снял теплораспределительную крышку и вот пожалуйста результат.

реклама
Всё осталось целым
Сразу отмечу, что термопаста под крышкой была уже довольно сухая, вероятно подобный термоинтерфейс деградирует со временем, что может проявиться на более мощных моделях ЦП при их длительном использовании.
Я немного почистил герметик с поверхности платы, без особого фанатизма, так как приклеивать обратно на герметик не собирался.
Как произвести скальпирование процессора
Скальпирование можно произвести тремя способами, я рекомендую выбрать третий способ, а также перед процедурой скальпирования обязательно сделать фото своего процессора и купить термостойкий герметик, далее расскажу зачем.
- С помощью лезвия, аккуратно попытаться поддеть крышку и срезать клей, как вы понимаете это очень опасный способ, лезвием мы можем повредить текстолит или контактные дорожки, не советую его использовать неопытному пользователю
2. Зажать текстолит процессора в тиски, конечно же переусердствовать не надо, все делаем аккуратно, затем прогреваем металлическую крышку процессора паяльным феном или газовой горелкой и отделяем ее от самого текстолита. Способ считается также достаточно опасным.
3. Купить специальное приспособление под названием скальпатор , предназначенное для вашего процессора, этот метод самый безопасный и вы точно будите уверены, что с вашим процессором ничего не случится. Все что Вам нужно будет сделать это положить процессор в скальпатор и начать закручивать винт, до тех пор, пока у нас не сдвинется металлическая крышка от текстолита, как только это произошло, то извлекаем процессор из скальпатора и снимаем руками металлическую крышку.
Припой, как все выглядит.
В настоящее время процессоры производятся и имеют внешний вид кремниевой микросхемы. Кремний является основным материалом для создания процессоров, обладая кубической кристаллической решеткой можно создавать идеальные слои на атомном уровне. Таким образом после создания интегральной схемы, на аерхней части подложки будут размещены металлизированные площадки для соединения чипа с печатной платой, припой в виде шариков обеспечит надежность соединения чипа. Сама матрица чипа, будет производить и выделять достаточно большое количество тепла, относительно своих физических размеров, по этому нужен хороший теплоотвод . Одновременно возникает другая проблема в текстолите socket LGA, его толщина всего около 1,17мм (процессор Haswell ), но процессор Skylake имеет толщену текстолита около 0,78 мм. Текстолит будет давать идеальное подключение к контактам LGA в гнезде материнской платы . Главная проблема, как соединить кристалл, изготовленный из кремния и теплораспределительную крышку, произведенную из меди. Медь имеет теплопроводность около 400 Ват, плюс она доступна. Есть много способов все это соединить, но реально мы столкнемся с множеством факторов, самый главный — это максимальная температура которую может выдержать чип кремния и теплопроводность совместимых материалов.

Вся правда о пайке или скальпирование CPU
На рисунке видно как схематично выглядит процессор intel поколений lvy Bridge, Haswell, Skylake. Видно что, подложка соединяется с печатной платой через столбики припоя, которая в конечном итоге соединяет процессор с socket LGA. Виден так называемый не долив, тот что на печатной плате, основание и выступающая часть имеют разные коэффициенты теплового расширения, таким образом недолив защищает процессор от саморазрушения, вызванного разностью коэффициента теплового разрушения. Теплораспределительная крышка будет проводить тепло от подложки к радиатору, который будет крепиться на теплораспределительную крышку сверху. Термоинтерфейс должен быть пластичным и должен компенсировать все движения из-за разности теплового расширения, без повреждений кристалла процессора. В зависимости от типа процессора, между подложкой и теплопроводящей крышкой, можно применять обычную термопасту или припой.

Вся правда о пайке или скальпирование CPU
После я занялся кристаллом

Не очень аккуратно получилось
Тут в общем история повторилась. Кремний совершенно не смачивался припоем, опять помог самопальный флюс.
Скажу сразу, что у меня получилось нормально припаять только с пятой попытки, до этого я провёл один краштест, сорвав припаянную крышку с кристалла, чтобы посмотреть пятно смачивания.
С одной стороны, в месте где припой хорошо смачивал кристалл, я сорвал припой вместе с тонким слоем кремния, это было видно визуально. То есть добиться лучшей адгезии уже, наверное, нельзя.
Другое дело, что несмотря на то, что я предварительно облудил и крышку и кристалл, реальное смачивание кристалла явно не превышало и половины площади, а может быть и меньше, было большое количество пустот, что очень плохо.
Пайка процессора с крышкой.

Вся правда о пайке или скальпирование CPU
Привычной для нас пайкой тут не отделаешься, крышка из меди а кристалл из кремния, при этом сроки эксплуатации готового процессора составляют многие годы, это накладывает особый отпечаток на качество работ. По этому нужно правильно и качественно подготовить все составляющие для пайки, это теплораспределительная крышка и подложка ( кристалл процессора). Теплопроводящая крышка (платина) покрыта слоем никеля (Ni), никель будет работать в качестве диффузионного посредника для качественного соединения с медью. Индий тоже цепляется за никель но не так хорошо как хотелось, поэтому понадобится еще один слой, желательно из благородного металла, на пример золото (Аu), серебро (Ag) или палладий (Pd), поскольку может обеспечить более стабильное прилипание. Золото по всем параметрам подходит лучше для пайки. Золото нужно наносить на пластину слоем 1-3 мкм.
Почему же самопальный припой под крышкой не принёс кардинального преимущества перед засохшей термопастой?
Ответ прост, я не смог добиться большой площади смачивания кристалла припоем, на термораспределительной крышке тоже, вероятно, есть пустоты. Это при том, что результаты пайки совершенно невозможно проверить, я спаял, заклеили крышку и только после этого узнал: повезло или нет. Ну и TDP устройства всего 35 Вт.
В общем технология вполне реализуемая в кустарных условиях, но ещё требует определённой доработки в плане реализации, и пока лучше использовать для этих целей традиционный "Жидкий металл".
Подпишитесь на наш канал в Яндекс.Дзен или telegram-канал @overclockers_news - это удобные способы следить за новыми материалами на сайте. С картинками, расширенными описаниями и без рекламы.
Запланированное устаревание помогает обогащению корпораций, но страдают в итоге потребители за свои же деньги.

реклама
Запланированное устаревание помогает обогащению корпораций, но страдают в итоге потребители за свои же деньги, и в данной статье я поделюсь одним из случаев, когда запланированное устаревание сработало как задумывалось производителем.
Началось веселье с того что ПК перестал нормально работать, друг принес мне системный блок и говорит что-то там с жестким диском наверное проблемы, там пыль почистить, термопасту поменять и т.п., проще говоря сделать чтобы оно нормально работало.
Это был системный блок с системной платой GA-MA69VM-S2, процессором Athlon64 x2 4400+, 1 GB DDR2 800, SATA HDD WD какой-то на 250 GB с пломбой 2009 года, видеокарта GeForce 7300 GT на 256 MB.
ПК за десяток лет судя по всему никто не чистил, я конечно почистил ПК как мог, пришлось полностью разобрать, в том числе и БП, но были обнаружены старые следы неизвестной жидкости и коррозия местами на системной плате и видеокарте.
 |  |
реклама
Изначально на ПК была установлена непонятная сборка Windows (XP), с 1 ГБ памяти большее вряд ли выйдет использовать.
В общем система загружалась, показывала ошибки разнообразные, там уже по классике паразитировал антивирус на который я даже внимания не обращал ибо в любом случае мне сказали все удалять и не заботится о данных.
Далее я добавил модуль памяти на 2 ГБ ибо меня просили добавить если будет, загрузившись со своего SSD операционная система начала чинить файловую систему HDD, после я запустил TestMem5 проверить нет ли ошибок ОЗУ, полностью проверил жесткий диск на битые сектора, но проблем абсолютно никаких, жесткий диск вообще в идеальном состоянии оказался.
Я не планировал из этого делать статью потому прикрепляю что есть.
 |  |  |
реклама
И только после того как убедился что все работает нормально я принялся устанавливать чистую операционную систему.
Установил обновления за исключением вирусов от Microsoft принуждающих к переходу на Windows 10, фреймворки тоже чтобы другу потом не ломать голову с типичными ошибками vcredist'ов, и тут начались странности.
Когда я отходил на длительное время было замечено что ПК выключен к моменту когда я возвращался, а операционная система говорила что завершение работы было непредвиденным.
реклама
Я сразу понял в чем дело, ведь и термопасты не пожалел при сборке, и охлаждение работало исправно.
 | 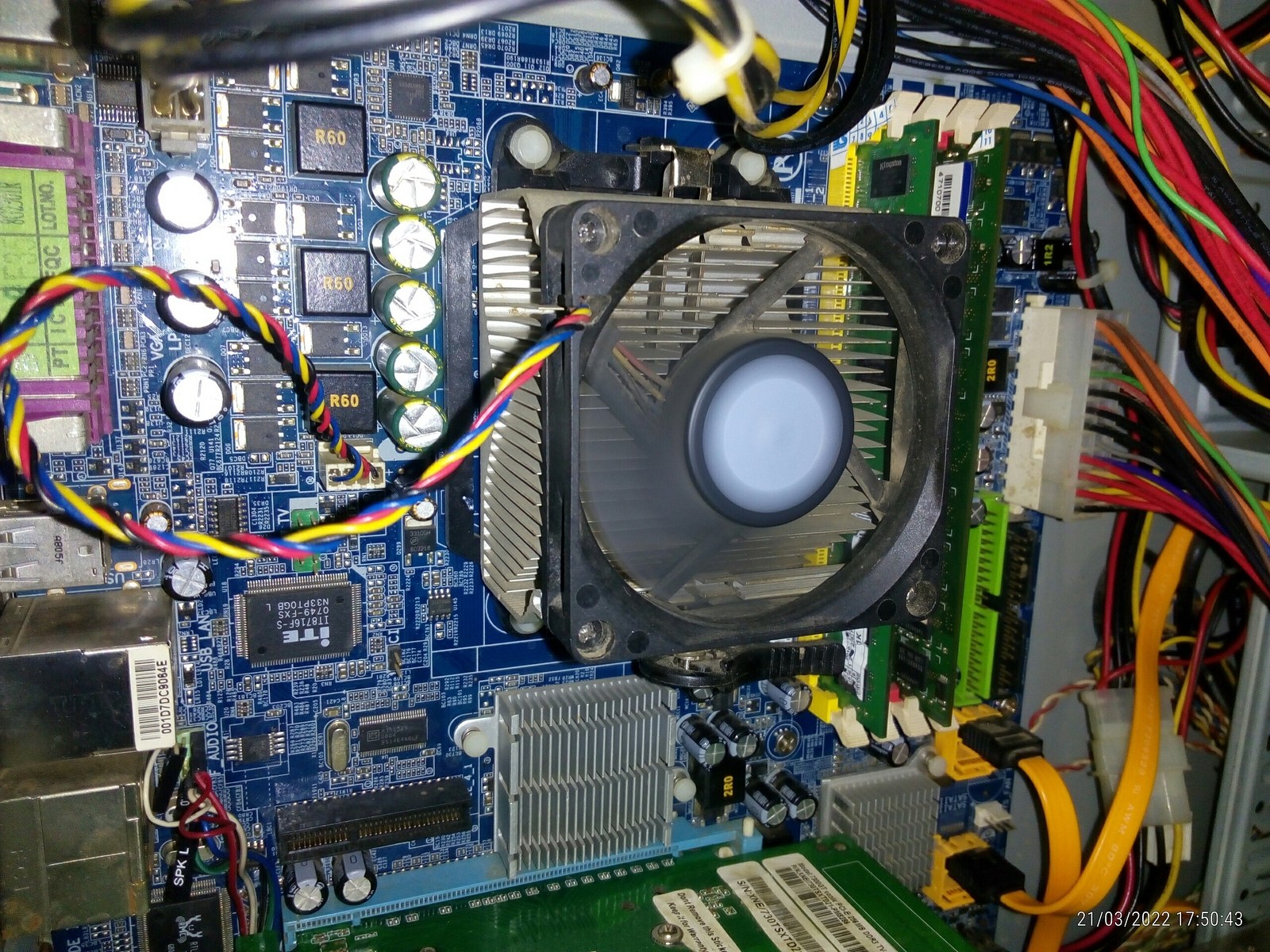 |  |
Думаю некоторые уже поняли к чему эти две фотографии.
 |  |
Да, время расчехлить лезвие для скальпа, что в последний раз безуспешно пыталось скальпировать ядрёный компаунд nVidia GTX 570.

Я старался не заглублять лезвие слишком глубоко, ведь под крышкой есть множество SMD элементов которые можно повредить, один раз я даже коснулся лезвием одного из них, но я скальпировал аккуратно и без фанатизма потому касание обошлось без последствий.
В любом случае человек не сможет использовать процессор, который не может нормально работать по вине производителя заложившего запланированное устаревание в конструкцию процессора, даже если я испорчу процессор друг поймет ситуацию.
 |  |  |
Убрав старый мусор от AMD я подготовил GD100 просто потому что у неё хорошая консистенция в отличие от более дорогой HY510 и ей подобных паст, а еще не происходит значительного расслоения со временем.
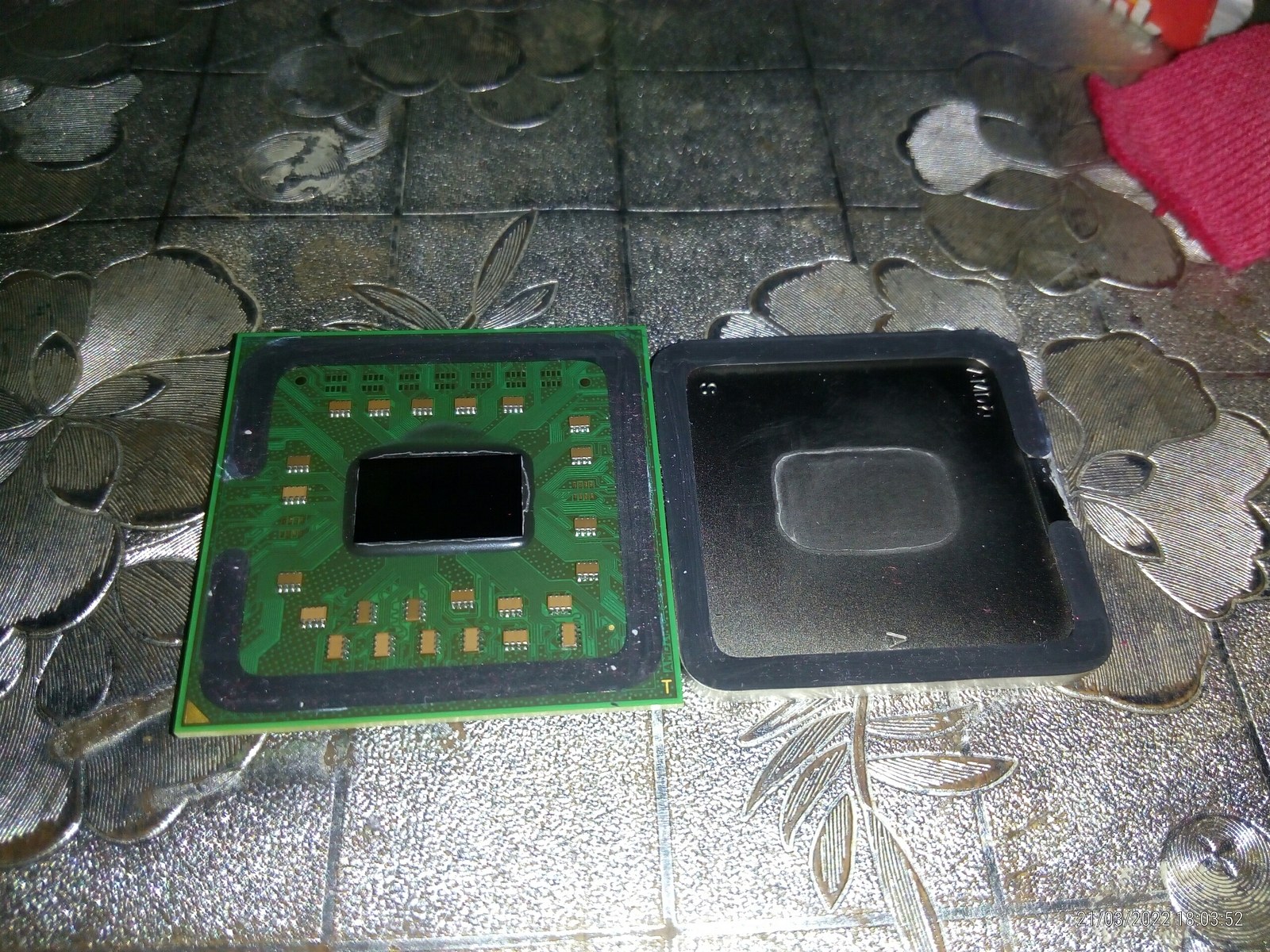 |  |  |
Немного стер компаунд чтобы крышка плотнее прилегала к кристаллу и по углам зафиксировал силиконовым герметиком, в таком состоянии следует сжать процессор, проще всего установить в систему и прижать радиатором.
 |  |
Термопасту я вообще убрал с радиатора, зная качество старых AM2 брусков термопаста порой имеет мало смысла при установке на Athlon.
Тем более при хорошем качестве поверхности радиатора и ЦП можно получить ситуацию когда радиатор присасывается к процессору, а это усложняет снятие радиатора.
 |  |
В общем несмотря на дешевую GD100 с неизвестным зазором так как герметик я не убирал полностью, температурный режим процессора пришел в более адекватный режим, только при тестировании FPU температура выходит за 90 градусов.
 | 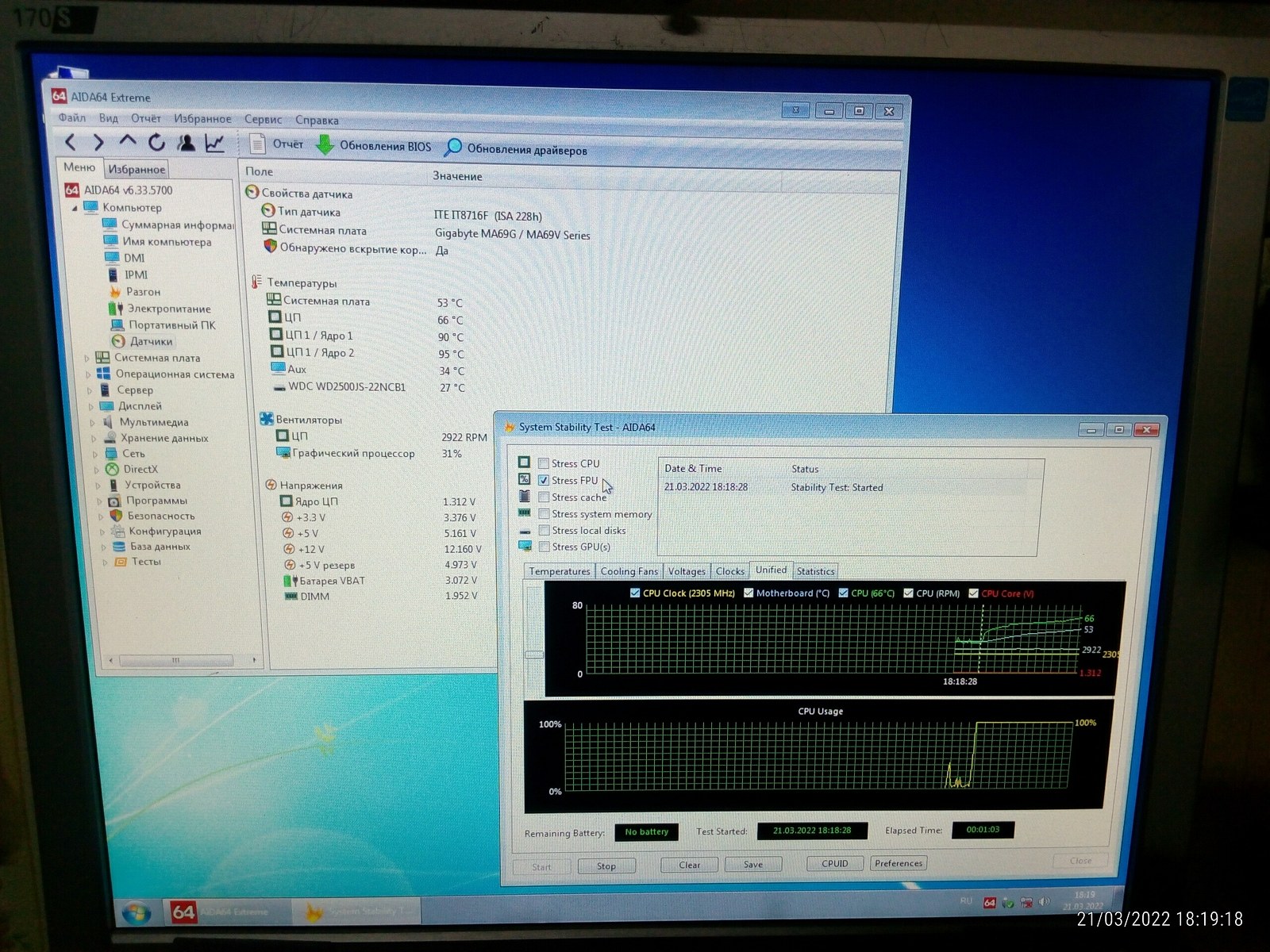 |  |
Но оставлять человеку такой процессор я не хотел, потому установил более новый и производительный Athlon II x2 215, снова без термопасты устанавливаю брусок охлаждения, проблем никаких даже при нагрузке на FPU.
Системная плата о таком процессоре даже не знает, но работает.
 |  |  |  |
На всякий случай я решил обновить BIOS в системной плате, тем более Gigabyte добавила микрокоды на процессоры второго поколения (AM3) хотя плата изначально выпускалась как AM2, это наглядный пример как от программной части зависит работоспособность реального оборудования.
Тот же Asus не удосужился в AM2 плату (точную модель которой я уже забыл) добавить микрокоды AM3 процессоров тем самым принуждая покупателя выбрасывать "старое и никчемное" и покупать "новое".
Вернемся к обновлению BIOS у Gigabyte, встроенная утилита работает только с Floppy дисками.
 |  |  |
Пришлось записывать DOS на флешку и прошивать утилитой что Gigabyte предоставляет вместе с прошивкой, визуально изменений мало между F7 и F10e прошивками, пропала надпись 64-bit говорящая что ОЗУ работает в один канал.
К слову, ОЗУ так и не заработала в двухканальном режиме после обновления BIOS, не знаю в чем дело (количество ранков, прошивка платы или физический дефект), но точно не в расположении модулей, я проверял разные положения модулей ОЗУ в слотах.
 |  |  |
Естественно я сделал повторные тесты производительности, и с новым микрокодом заметно снизились задержки доступа к ОЗУ, в остальном особой разницы я не обнаружил.
 |  |
На этом собственно все, как меня и просили я починил ПК.
Пришлось правда процессор заменить за что спасибо AMD что наложили термопасту вместо припоя в некоторые процессоры.
Конечно, нет более злостной корпорации чем Intel в плане злоупотребления термопастой под крышкой процессоров, но nVidia тоже не постеснялась одно время злоупотреблять термопастой, и AMD тоже оставили в своей истории данное позорное пятно, но я уже давно не удивляюсь последствиям.
Я искренне рад тому что избавился в свое время от i7 6700K заменив на более производительный в целом R5 1600, я могу только посоветовать обходить стороной вещи в которых применены подобные методы запланированного устаревания физически наносящие вред оборудованию.
Стоит понимать что корпорации продают свои творения с "закладками" всегда за полную себестоимость и дороже, думаю ситуация с запланированным устареванием изменится только когда потребитель начнет думать перед покупкой устройства набитого "закладками" принуждающими к апгрейду там где этот апгрейд в принципе не нужен.
Тем более не стоит забывать что каждое электронное устройство может работать очень долго и приносить реальную пользую, а когда производители прибегают к запланированному устареванию огромное количество электроники искусственно превращается в мусор который невозможно использовать, экологи вы где?
На этом все, благодарю за внимание.
Подпишитесь на наш канал в Яндекс.Дзен или telegram-канал @overclockers_news - это удобные способы следить за новыми материалами на сайте. С картинками, расширенными описаниями и без рекламы.
Как известно, многое любитель бескомпромиссного разгона добивались улучшения контакта процессор-кулер путем снятия теплораспределительной крышки с процессора. К сожалению однозначно сказать, будет ли положительный результат такой операции заранее невозможно, в удачном случае удается отыграть только пару-тройку градусов, что компенсируется более сильным прижимом защищенного крышкой ядра. С другой стороны в случае потрескавшегося или некачественно нанесенного термоинтерфейса выигрыш по некоторым заявлениям может достигать десятка градусов.
К тому же несколько лет назад была разработана технология припаивания крышек, которая с тех пор используется и интел и амд на степпингах используемых в топовых процессорах. Теоретически, это наконец должно было обеспечить идеальный интерфейс с кр.
Как известно, многое любитель бескомпромиссного разгона добивались улучшения контакта процессор-кулер путем снятия теплораспределительной крышки с процессора. К сожалению однозначно сказать, будет ли положительный результат такой операции заранее невозможно, в удачном случае удается отыграть только пару-тройку градусов, что компенсируется более сильным прижимом защищенного крышкой ядра. С другой стороны в случае потрескавшегося или некачественно нанесенного термоинтерфейса выигрыш по некоторым заявлениям может достигать десятка градусов.
К тому же несколько лет назад была разработана технология припаивания крышек, которая с тех пор используется и интел и амд на степпингах используемых в топовых процессорах. Теоретически, это наконец должно было обеспечить идеальный интерфейс с крышкой, однако по некоторым неизвестным причинам это не так. Во первых, толщина припоя составляет примерно пол миллиметра, что уже дает похожее с тонким слоем термопасты теплосопротивление, к тому же качество нанесения припоя оказывается еще хуже пасты, иногда остаются непропаяные пузыри воздуха. Однако снять крышку на припое гораздо более нетривиальная задача по сравнению с обычной термопастой. Некоторые особо одаренные оверклокеры дошли до использования отверток или газовых горелок для отдирания крышки . Не стоит и говорить, что чаще всего это оканчивалось отломаным ядром или нарушеным контактом с подложкой из-за перепада температур.
Итак сегодня я не буду снимать крышку с процессора армейским способом ;)

Во первых сам процессор:
Извесный тормоз Celeron D 2,4ГГ по три рубля пяток (2 шт).
Как всегда отказ от ответственности, если Вы следуя данной статье повредите дорогостоящее оборудование или устроите пожар, вините в этом только собственные руки или карму ;) Так же нет гарантии,что другие процессоры произведены по такой же технологии.
Также перегрев может быть вызван просто кривым основанием кулера или крышки, дающим зазор при большой площади контакта.
Скальпель для разрезания резины в виде совкового лезвия :


Вторую сторону обрезаем, это сильно снижает количество потеряной крови.
Тут же хочу заметить что прервое что приходит в голову, разрезать резину канцелярским ножом - НЕ ГОДИТСЯ. Если лезвие толщиной 0,1 мм входит в полумиллиметроый слой резины как нож в масло(ну почти ;) ) то вбивая туда же лезвие ножа толщиной 0,3мм, в случае термопасты придется сильно попотеть, а отжимая припаяную к ядру крышку скорее всего разрушится пайка между упаковкой процессора и ядром.
Также не надо забывать про конденсаторы, которые могут быть под крышкой. Неплохо было бы найти фотографию такого процессора со снятой крышкой и нарисовать маркером на крышке границы резины и элементов под ней.
После всех этих предосторожностей резина под крышкой не должна доставить проблем, втыкаем лезвие 8 раз со всех сторон и крышка срезана. Если между ядром и крышкой была термопаста, то крышка тут же и снимается чем-нибудь острым, например тем же канцелярским ножом.

С припоем надо еще немного повозиться. Для того, чтобы процессор был хорошо закреплен, а крышка могла свободно упась вниз, я сделал простейший зажим, подойдет любой тонкий лист металла:

Для того, чтобы крышка с гарантией отвалилась, я воткнул пару обломков ножа в зазор:

Собираем эту конструкцию и отправляем в духовку пропекаться. При температуре около 180 градусов припой под крышкой расплавился, и она отвалилась от процессора. Выключаем печь и ждем пока все остынет. Под действием силы тяжести, а также большей смачивоемости крышки почти весь припой остался на ней.
Оба процессора успешно работают после установки крышки обратно через термопасту под боксовым кулером.

Подпишитесь на наш канал в Яндекс.Дзен или telegram-канал @overclockers_news - это удобные способы следить за новыми материалами на сайте. С картинками, расширенными описаниями и без рекламы.
Многие обладатели процессоров intel в скором времени столкнутся с процедурой скальпирования своего процессора, а все это потому, что под крышку процессора с 2012 года вместо припоя была нанесена термопаста, которая со временем теряет свои свойства . Особенно это актуально для процессоров intel с возможностью разгона т.е. индексом К .
Кстати у AMD такой проблемы на новых процессорах Ryzen нет, у них под крышкой расположен припой и смысла проводить скальпирование на таком процессоре нет, но на более старых процессорах(сокет АМ2,АМ3) также использовалась термопаста.
Процесс пайки.
Итак получилось: Никелерованная теплораспределительная крышка сверху, снизу слой золота для связи с индием, еще ниже три слоя, титан, никель + ванадий и золото. Температура пайки должна быть не выше 170 ° С. Меньше температура может привести к плохой диффузии всех компонентов а высокая к выходу из строя процессора. В процессе пайки будут образовываться сплавы из некоторых компонентов. После пайки видно что золото, индий и никель образуют сплавы различной толщины. Теперь теплораспределительная крышка припаянна к кремнию и готова к работе.

Вся правда о пайке или скальпирование CPU
Что такое скальпирование процессора
Давайте разберемся, что это такое скальпирование. Возможно уже кто-то догадался или знал, что под скальпированием мы понимаем снятие металлической крышки с процессора, и замены термопасты на жидкий металл или новую термопасту . Часто эта процедура производится энтузиастами, которые хотят добиться более низких показателей температуры, но выше мы уже упоминали, что возможно такую процедуру придется проводить и обычному пользователю, над этим нужно задуматься если Ваш процессор стал сильно греться , и банальная чистка от пыли и замена термопасты на крышке процессора не помогает .
Перед скальпированием обязательно проверьте, что под крышкой вашего процессора именно термопаста , сделать это можно с помощью поисковых систем.
Припой.
Как было описано выше, индий является единственным материалом который годится для использования. В зависимости от формы индия мы должны удалить оксидный слой перед пайкой. Это может быть сделано путем селективного травления с использованием хлористоводородной кислоты. Слой индий должен быть толстым, чтобы обеспечить достаточное количество циклов тепловом расширения без образования трещин, при многократных термических процессов. И мы не можем припоять индий к кристаллу процессора, так как индий будет диффузировать в кремний, что не избежно со временем выведет чип процессора из строя. Таким образом нужен еще один диффузионный барьер слой на верхней части чипа. Диффузионный барьер формируется из нескольких слоев, выполненных из титана (Ti), никель (Ni) и ванадия (V). Сверху этого бутерброда, лежит слой золота для лучшего прилепания индия.

Вся правда о пайке или скальпирование CPU
Читайте также:


